半导体器件焊接热综合试验 试验背景
焊接热试验会使SMD中潮气(SMD在存贮期间吸收的)气压升高,从而导致SMD塑料封装破裂和电气性能失效。半导体器件焊接热综合试验通过模拟贮存在仓库或干燥包装环境中SMD吸收的潮气,进而对其进行耐焊接热性能的评价。
中科检测环境可靠性实验中心拥有各种半导体器件机械和气候试验设备,具备焊接热综合试验能力,为半导体器件、设备提供专业的焊接热综合试验服务。
中科检测环境可靠性实验中心拥有各种半导体器件机械和气候试验设备,具备焊接热综合试验能力,为半导体器件、设备提供专业的焊接热综合试验服务。
半导体器件焊接热综合试验 试验方式
1、初测:外观检查、电测试、声学扫描内部检查
2、干燥
3、水汽浸渍:非干燥包装的SMD试验条件、干燥包装的SMD水汽浸渍
4、焊接热:红外对流或对流再流焊接的加热方法、气相再流焊接的加热方法、波峰焊的加热方法
5、恢复 6、最终检测:外观检查、电特性测试、声学扫描检查
2、干燥
3、水汽浸渍:非干燥包装的SMD试验条件、干燥包装的SMD水汽浸渍
4、焊接热:红外对流或对流再流焊接的加热方法、气相再流焊接的加热方法、波峰焊的加热方法
5、恢复 6、最终检测:外观检查、电特性测试、声学扫描检查
半导体器件焊接热综合试验 试验标准
GB/T 4937.1-2006 半导体器件机械和气候试验方法 第1部分:总则
GB/T 4937.20-2018 半导体器件机械和气候试验方法 第20部分:塑封表面安装器件耐潮湿和焊接热综合影响
IEC 60749- 20: 2008 半导体器件机械和气候试验方法 第20部分:塑封表面安装器件耐潮湿和焊接热综合影响
IEC 60068-2-20:2008电工电子产品环境试验 第 2-20部分:试验方法试验T:带引线器件的可焊性和耐焊接热试验方法
GB/T 4937.20-2018 半导体器件机械和气候试验方法 第20部分:塑封表面安装器件耐潮湿和焊接热综合影响
IEC 60749- 20: 2008 半导体器件机械和气候试验方法 第20部分:塑封表面安装器件耐潮湿和焊接热综合影响
IEC 60068-2-20:2008电工电子产品环境试验 第 2-20部分:试验方法试验T:带引线器件的可焊性和耐焊接热试验方法

























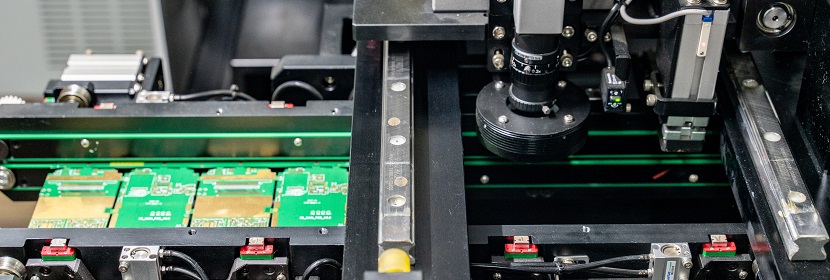
 立即咨询
立即咨询 留言咨询
留言咨询







